Temporary Bonding and Debonding
暫時鍵合系列設備
Made in Taiwan
客製自動化流程
為因應市場上標準機功能上不完全符合使用,我們提供軟體與硬體的客製化服務,精準的符合貴司的需求。
高性價比
設備在台灣設計、製造,為您省去與代理商溝通或與外國原廠做國際貿易的交機時間與高額費用。
打樣服務
我們提供以下打樣服務,尺寸涵蓋 4″~12″ 晶圓尺寸。
- Spin Coating
- Bonding
- Thermal Slide Debonding
- Mechanical Peel-off Debonding
- Laser Lift-off Debonding.
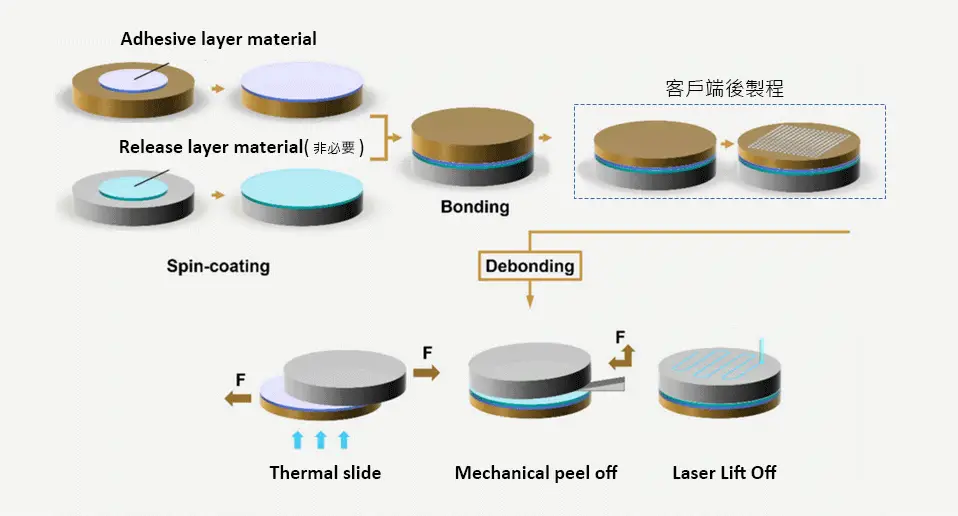
機台類型參考
FAQ
此系列設備為暫時性鍵合(adhesive bonding)製程設備,適合晶圓薄化製程前的暫行性鍵合與解鍵合流程。
晶圓(wafer)
Size:4″、6″、8″、12″
載片(carrier)
Size:可選wafer做等徑或異徑貼合。
FOUP, FOSB, Open cassette, Coinbox, Frame Type
基礎功能:
1. 偵測卡匣放置異常。
2. 掃描卡匣判別晶圓有無片、凸片、斜片、疊片
(翹曲片無法辨識斜、疊片)。
其他選配功能:
1. 讀取Cassette ID / 工單
2. 判讀晶圓錯片。
3. 可依需求,客製晶圓卡匣。
4. 其他客製需求。
依照需求可做客製化的設計。
目前接近的兩個尺寸可以做兼容設計,例如 4″& 6″、6″ & 8″ 、8″ & 12″。
中心點對位、NOTCH點對位、平邊對位、角度旋轉對位、判讀Wafer ID(選配) 等。
- 鍵合腔體有區分硬板式壓板、氣囊式壓板、UV固化腔體。
- 依照不同材料可選擇不同鍵合腔體,歡迎進行樣品打樣。
熱滑移解鍵合(Thermal slide debond):
- 解鍵合設備可做全自動或半自動機型。
- 以極輕的方式接觸載片,將其加熱、以高平行度的方式進行分片。
- 解键合最薄晶圆厚度≧50um。
可自動偵測各種厚度晶圓,無須進行任何調整。
* 其他規格請到設備頁面瞭解—前往。
機械剝離(Mechanical debond):
- 以物料區分,有鐵框與無鐵框的機型。
- 將晶圓與載片產生破口後,以機械方式將其分開。
雷射分片(Laser lift of):
- 雷射掃描範圍可支援 2″~12″ wafer。
- 355nm、1064nm波段雷射可進行打樣測試。
- 可控制塗佈方式(單點或由內到外)以及塗佈時間。
- 以旋轉方式均勻擴散黏著劑(adhesive)或洗劑。
- 可支援黏著劑(如Brewer、日化精工、3m等)、洗劑(丙酮、IPA、正己烷等)、氣源(氮氣等)。(如有使用其他化學藥劑,可提供樣品進行測試。)
- 具備背洗和洗邊功能。
* 其他規格請到設備頁面瞭解 — 前往
可以。詳細軟體需求需進一步討論。
>> 可依照需求做ESD防靜電設計規劃。
若有需求,請依下方格式提供規格,讓我們為您做進一步評估:
1. Decay Time : +1000V→ +100V〔<5sec〕
2. Decay Time: -1000V → -100V〔<5sec〕
3. Ion Balance: 〔<35V〕
4. Inside the whole machine or some sites?
>> 機台有開放式和封閉式,可依需求做潔淨度設計規劃。




